
Chips stall at interfaces.
Power density rises.
Boundaries saturate.
Heat accumulates.
Losses compound.
Performance flatlines.
What changes
Across internal testing and external characterisation (including IEEE EPEPS), nSD-I has demonstrated:
- ~2× improvement in effective heat extraction
versus conventional copper-based interface interposer / RDL approaches
meaningful reductions in junction-to-ambient ΔT
at comparable power densities - ~40% improvement in electrical transport
at key interfaces
reduced resistive losses
reduced localised heating - improved thermal uniformity
reduced hotspot-driven degradation - lower effective thermal stress
longer usable lifetimes - cost parity with, or lower cost than,
the underlying wafer or substrate
In practice, these gains are realised at the interposer and RDL layers, where thermal, electrical, and mechanical limits most directly constrain advanced packages.

Baseline interposer (left): Vertical transport constrained at the interface, creating localized hotspots.
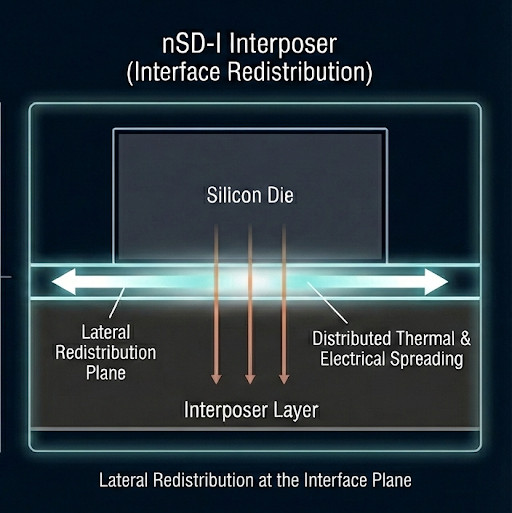
nSD-I interposer (right): Lateral redistribution at the interface plane reduces peak temperature and electrical stress without changing the vertical stack.
Illustrative schematic. Transport paths shown for conceptual clarity; not to scale.
The result
- higher sustained performance
- less thermal overdesign
- better performance per dollar
System gains depend on package architecture and integration depth.
What we do
Partners bring their designs.
Their substrates.
Their packaging stacks.
We engineer nSD-I thermal and electrical interface devices.
We embed into existing stacks.
Or co-engineer the package where needed.
We don’t manufacture chips.
We take responsibility for interface performance.
How it fits
- integrates into existing packaging flows
- avoids exotic tooling
- validated through pilots before scale
Partners keep the architecture.
We fix the interface.
Flagship deployment:
Thermal and electrical interface devices deployed as advanced packaging interposers and RDLs in high-density chip systems.